測定の不確実性を低減
統合されたΔPセンサーアセンブリ
あらゆるプロセス条件に対応
層流エレメント
精密で再現性のあるガス供給
ダウンストリームバルブアーキテクチャ
バルブのリークバイを100倍改善
設計されたPCTFEシール面

測定の不確実性の低減
真の差圧センサー優れた流量測定精度と再現性。
従来の圧力ベースのMFCは、圧力降下を計算するために2つの絶対圧センサーを使用していました。GP200シリーズは、1つの絶対圧センサーと真の差圧(ΔP)センサーの統合アセンブリという新しいセンサー・アプローチを採用しています。
- 2つの絶対圧センサーで校正と温度補正を行う必要がありません。
- 制御不能なドリフトと流量の不正確さを防ぎます。
- 優れた長期安定性を実現
あらゆるプロセス条件に対応
あらゆる圧力、あらゆるガス、あらゆるプロセス。
従来の圧力ベースのMFCは、高い入口圧力を必要としました。GP200シリーズでは、層流エレメントは低圧力降下用に設計 さ れ、差圧センサーは最適に配置 されて いるため、半導体製造に使用される難しい低蒸気圧プロセスガスの正確な流量測定が可能です。
この独自のアーキテクチャにより、GP200シリーズは標準圧力ガスと重要な低蒸気圧ガスの両方に適したユニバーサルP-MFCソリューションとなり、あらゆる運転条件下で精度と再現性を保証します。
- 35psiaはGP200シリーズの典型的な入口圧力仕様ですが、特定の用途に応じて、より高圧または低圧に設定することができます。
- 以下のような重要な低圧プロセスガスに対応するよう設計されています:
- BCl3
- C4F6-q
- C4F8
- SiCl4
- クロストーク・インセンシティブ ≤ 40 psi/秒のインレット圧力スパイクまで設定ポイントの±1
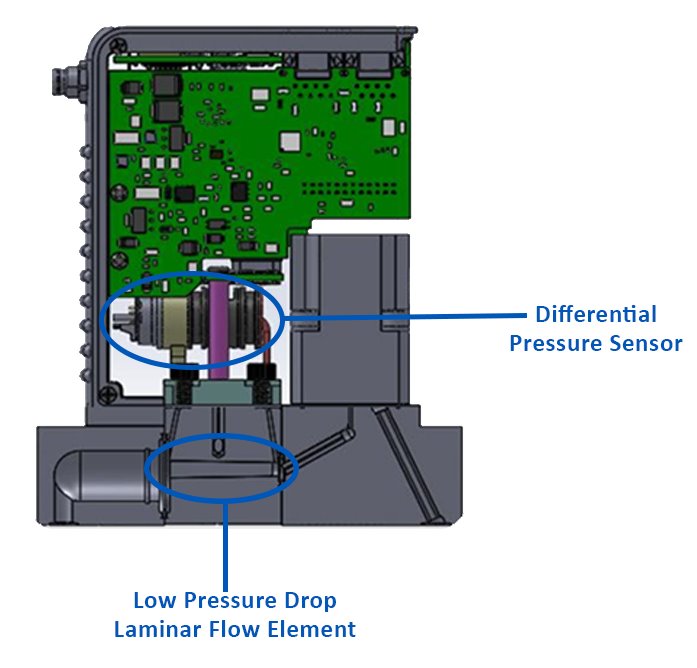


正確で再現性のあるガス供給
2.5倍の高速フロー安定化によりウェーハスループットを向上。
昇降流の安定化時間に対して超高速で再現性が高く、ブリードダウンのタイムラグがありません。
GP200シリーズは、パルスガスインジェクション、ミキシングマニホールド、フロースプリッターサブアッセンブリーによる背圧の変化の影響を受けません。独自のダウンストリームバルブ構造により、層流エレメントとΔPセンサーをダウンストリームのクロストーク(圧力変動)から隔離することで、ダウンストリームの圧力に依存しない誤差を可能にし、1200Torrという高いダウンストリーム圧力への流量供給を可能にします。
下流側のバルブは、枯渇するガスの可変内部容積がないため、迅速なシャットダウンと、パルスガス供給用のレシピ設定ポイントの切り替えが可能です。過渡変動は、膜厚変動や電気的変動につながります。
速いステップダウン応答と一致した過渡応答は、低流量セットポイントに移行する際の長いブリードダウン時間遅延を 取り除きます (「テール効果」を取り除きます)。
バルブのリークバイを100倍改善
ゼロ・リークバイ・コントロール・バルブがファースト・ウエハー効果を排除します。
MFCコントロールバルブを横切ってガスリークバイが発生すると、下流の空気圧隔離バルブで不要な圧力が上昇し、閉じ込められたガス体積が形成されます。
新しいレシピシーケンスが開始されると、この閉じ込められたガス量がプロセスチャンバーに入り込み、ファーストウェーハ効果と呼ばれる、最初のウェーハ上の不均一性とクリティカルディメンション(CD)欠陥を引き起こします。プロセスエンジニアは、ダミーウェーハを使用するか、ウェーハを処理する前に流れを排気に転換することで、ファーストウェーハ効果を回避します。
オプションのゼロ・リーク・バイ・コントロール・バルブは、PCTFEシール面を持つため、バルブのシャットダウンが改善され、ファースト・ウェーハ効果を排除します:
- <0.005%FS(ビン42-46の場合
- <0.02%FS(ビン40-41の場合

ホワイトペーパー
先端半導体プロセス用差圧センサベースの新型MFC
新しいGP200シリーズP-MFCにおいて、ディスクリート圧力センサの代わりに差圧センサを使用し、層流エレメントの下流に制御バルブを配置することで、従来のP-MFCと比較して流量測定精度と再現性に明らかな利点が得られることをご覧ください。
GP200シリーズと従来のP-MFCの違いは?
GP200シリーズのユニークな設計アプローチが、P-MFCのCVDプロセスへの利用をどのように拡大するかをご覧ください。
ブルックス・インストゥルメントで可能性を発見する
適切なソリューションを見つける準備ができていますか?当社のエキスパートがご案内します。製品の検索、サポートのご依頼、または代理店へのお問い合わせはこちらから。






