降低测量不确定性
集成式 ΔP 传感器组件
适用于所有工艺条件
层流元件
精确、可重复的气体输送
下游阀门结构
阀门泄漏率提高 100 倍
工程设计的 PCTFE 密封面

降低测量不确定性
一个真正的压差传感器。卓越的流量测量精度和可重复性。
传统的基于压力的 MFC 使用两个绝对压力传感器来计算压降。GP200 系列采用新颖的传感器方法 - 一个绝对压力传感器与一个真压差 (ΔP) 传感器的集成组件。
- 无需对两个独立的绝对压力传感器进行匹配校准和温度补偿
- 防止失控漂移和流量误差
- 实现卓越的长期稳定性
适用于所有工艺条件
所有压力、所有气体、所有工艺。
传统的基于压力的 MFC 需要较高的入口压力才能工作。GP200 系列则不同 -层流元件 专为 低压降而设计,压差传感器的范围 达到最佳 ,可对半导体制造过程中使用的具有挑战性的低蒸汽压工艺气体进行精确的流量测量。
这种独有的结构使 GP200 系列成为一种通用的 P-MFC 解决方案,既适用于标准压力气体,也适用于关键的低蒸汽压气体,确保在所有操作条件下的精度和可重复性。
- 35 psia 是 GP200 系列的典型入口压力规格,但可根据具体应用配置较高或较低的压力。
- 设计用于支持关键的低压工艺气体,包括
- BCl3
- C4F6-q
- C4F8
- SiCl4
- 对串音不敏感 ≤ 40 psi/sec 以下入口压力峰值设定点的 ±1
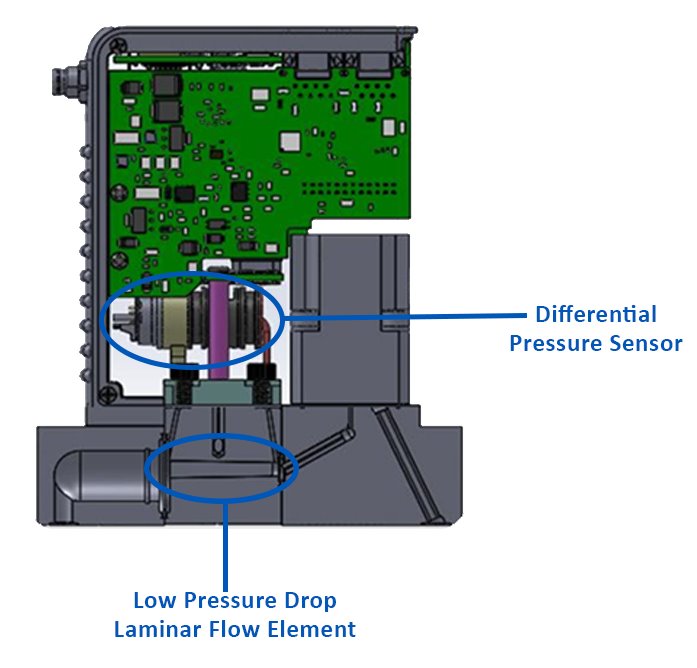


精确、可重复的气体输送
流量稳定速度快 2.5 倍,可提高晶圆吞吐量。
对上升和下降流量稳定时间的响应速度超快,重复性高,没有长的放气时间延迟
GP200 系列不受脉冲气体注入、混合歧管和分流子组件产生的不同背压的影响。独有的下游阀结构将层流元件和 ΔP 传感器与下游串扰(压力变化)隔离开来,从而使误差不受下游压力的影响,可在高达 1200 托的下游压力下进行流量输送。
由于没有可变的内部气体消耗量,下游阀门可快速关闭和切换脉冲气体输送的配方设定点。瞬态变化会导致薄膜厚度变化和电气变化。
匹配的瞬态响应 和 快速降压响应 消除了 过渡到低流量设定点时较长的放气时间延迟(消除了 "尾部效应")。
阀门泄漏率提高 100 倍
零通过泄漏控制阀消除了第一晶片效应。
当气体泄漏穿过 MFC 控制阀时,会在下游气动隔离阀处造成不必要的压力积聚,从而形成滞留气体。
当启动新的配方序列时,这些滞留气体会进入制程室,导致第一个晶片上出现不均匀和临界尺寸 (CD) 缺陷,这就是所谓的第一个晶片效应。工艺工程师可通过运行假晶圆或在处理晶圆之前将气流导入排气管来避免首晶圆效应。
可选的零泄漏控制阀具有工程设计的 PCTFE 密封面,可改善阀门关闭性能,消除第一晶片效应:
- 42-46 仓的 FS <0.005
- <0.02% FS(40-41 仓

白皮书
用于先进半导体加工的基于差压传感器的新型 MFC
了解新型 GP200 系列 P-MFC 如何使用压差传感器取代分立压力传感器,并将控制阀安装在层流元件的下游,从而在流量测量精度和可重复性方面比传统 P-MFC 具有明显优势。
GP200 系列与传统 P-MFC 相比有何独特之处?
了解 GP200 系列的独特设计方法如何将 P-MFC 的应用扩展到 CVD 工艺。





